2024.08.13
CAE 模擬預測 IC 封裝的翹曲與熱應力
CAE 模擬預測 IC 封裝的翹曲與熱應力

在當今科技飛速發展的時代,積體電路(IC)的封裝技術扮演著關鍵角色,不僅保護 IC 晶片免受損壞,還有助於確保其性能和可靠性。然而,隨著 IC 設計越來越小型化和集成化,封裝的翹曲和熱應力問題日益重要,這些問題可能導致製造缺陷和性能下降。
Ansys 模擬軟體作為頂尖的工程模擬工具,為解決這些問題提供了全面的解決方案,透過強大的求解器,能夠準確模擬 IC 封裝在各種操作條件下的翹曲行為和熱應力分佈,並提前預測可能出現的風險,從而在早期設計階段就能夠進行優化和改進。
透過 Ansys Mechanical 進行翹曲與熱應力模擬分析
-
翹曲分析
電子設備尺寸的不斷縮小和功率密度的增加,IC 封裝的翹曲問題變得越來越頻繁出現,透過 Ansys Mechanical 可以模擬 IC 在封裝過程中的翹曲和應變分佈,進而預測可能出現的機械應力和破壞點。透過這些分析,工程師可以設計出更耐用、更可靠的封裝結構,以提高產品的整體性能和壽命。
.jpg) |
| 四分之一對稱翹曲模型 |
- 熱應力分析
IC 在運行過程中產生的熱量會使晶片和封裝材料發生膨脹或收縮,這將導致封裝內部的熱應力問題。Ansys Mechanical 可以模擬封裝結構中每個部分的熱應力分佈,這些模擬分析可以幫助工程師評估不同材料選擇和結構設計對熱性能的影響,以確保晶片在各種操作條件下都能保持安全的工作,從而增強產品的可靠性和穩定性。
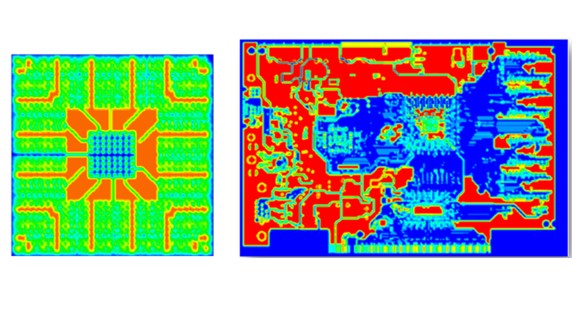
Ansys 模擬技術提升晶片封裝 2 倍的熱可靠度
力智電子(uPI SEMI)是一家半導體電源管理晶片的領導供應商,其產品用於高效能運算(HPC) 應用、通訊硬體、電池管理、工業設備和消費性產品。力智電子利用 Ansys 的模擬解決方案,加速其產品封裝解決方案的設計,並將熱可靠性提升了 2 倍之多。
藉由 Ansys 的模擬,力智電子得以快速預測其高效能晶片封裝設計的電氣、機械和熱特性,同時擁有可預測的準確性。這提升了產品的效能、簡化設計,並減少後期設計更動的風險。利用 Ansys 分析熱流和熱機械應力,力智電子最佳化他們的封裝設計,並將熱可靠度提升 2 倍,最初在 500 次熱測試迴圈後失敗的產品,透過 Ansys 的解決方案進行最佳化後可承受 1000 次以上的迴圈。
.jpg) |
| 利用 Ansys 多物理模型模擬 PRPAK 熱應力變化 |
力智電子封裝研發經理莊先生表示:「Ansys 的多物理場模擬解決方案使力智電子能夠優化我們的晶片封裝設計,並極大地提高產品可靠度,利用 Ansys 的模擬工具對電氣、熱和結構特性的關鍵洞察,我們的團隊加快了開發和驗證的速度,同時效率大幅提升,減少了設計錯誤,進而提升產品品質。」
Ansys 副總裁暨半導體、電子、和光學事業部總經理 John Lee 表示:「晶片封裝設計是非線性的,涉及複雜且多方面的工程,即便是小小的變化也會有意想不到的結果。Ansys 的模擬工具提供了端到端的多物理場分析,使團隊能夠快速洞察晶片封裝的多個領域,並具有可預測的準確性。有了 Ansys,力智電子能以最大程度提升他們的研發和可靠度測試過程,實現更高品質的產品。」
想了解更多資訊,或有任何相關需求,歡迎與我們聯繫 !
艾索科技股份有限公司 AISOL Technology
-
電話:02-2500-6210
-
郵件:info@aisol.com.tw

